硅的介电常数是多少(各种材料介电常数)
- 生活百科
- 用户投稿
- 2022-06-18 11:19:43
键合线脱落是IGBT芯片一种普遍的失效形式,铝键合线故障在一定程度上会影响门极杂散阻抗。杂散阻抗的改变又会引起门极电信号的变化,因此通过门极测量信号的变化来表征其杂散阻抗的改变,进而判断IGBT芯片是否发生铝键合线脱落故障。对门极杂散阻抗与键合线故障之间的关系进行了研究,为识别IGBT模块铝键合线故障提供了依据。
IGBT;铝键合线;杂散阻抗
绝缘栅双极晶体管(Insulated Gate Bipolar Transistor,IGBT)已成为高频大电流电力电子变换系统中应用最为广泛的一种功率半导体器件。据国外调查显示[1],在电力电子变换器中功率半导体器件是最脆弱的部分,故障率为31%。运行过程中功率器件损坏主要是由于功率波动导致温度波动产生的热机械应力致使器件及封装的机械形变和疲劳损伤累计[2-3],最终导致IGBT器件失效,铝键合线脱落是其最主要的失效模式之一。因此,监测IGBT铝键合线状态即检测其早期故障,是提高其运行可靠性的重要方法。
近年来,国内外对铝键合线失效、状态监测方面已有了大量研究。在失效分析方面,主要是通过仿真研究铝键合线脱落对模块性能的影响[4-6]。在状态监测方面,铝键合线失效首先会影响IGBT模块内部的布局,进而影响其端部特性[7-10],比如饱和压降、门极信号、阈值电压、关断时间等都可以作为状态监测参量反映器件的老化状态。总的来说,在IGBT器件失效机制和可靠性评估方面研究已经有了很大进展。现有可靠性评估方法各有优势,但也有其局限性。通过综合对比,本文采用门极电压的动态变化作为识别IGBT铝键合线故障的特征信号。
键合线脱落导致IGBT芯片内部等效电路发生变化,而这种变化会表现在门极电信号上。由于杂散阻抗难以测量,故可以通过门极电压信号的变化间接反映故障对杂散阻抗的影响。本文通过实验测取VGE,分析其在铝键合线故障过程中的变化规律,在此基础上利用小波并能量熵理论对门极电压信号进行次小波包分解并提取故障特征信息,为IGBT状态监测提供了依据。
1 IGBT模块的失效机理及结构特性
1.1 失效机理
研究功率器件失效机理是对其进行状态评估的基础。图1为IGBT模块的层状结构。各层材料的热膨胀系数(CET)不同,使得模块承受热冲击或循环加热冷却时,不同材料的热机械应力不同导致键合线熔断或脱落,最终导致IGBT模块失效。当器件在超过额定的电压或电流范围内工作时,可能产生过电应力,功率损耗增大,器件局部过热,甚至使材料熔化,形成短路或开路,也就是说电应力还会过渡到热应力,最终导致芯片失效。
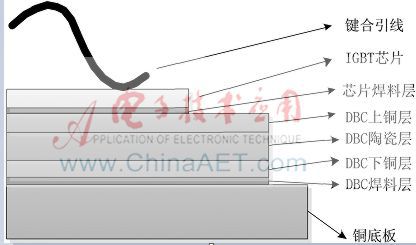
图1 IGBT封装结构示意图
通过上述分析,IGBT的失效过程可以概括为:器件工作过程中,热应力、电应力等因素使得IGBT模块内部的物理参数发生变化,通过铝键合线的电流重新均流,使得通过个别铝键合线的电流增大,从而加速铝线的熔断,当所有铝键合线都脱落时就会造成芯片失效。
1.2 结构特性
铝键合线发生脱落故障后影响IGBT器件整个杂散参数网络。门极电路的杂散参数来自于铝键合线和IGBT芯片。
铝键合线与芯片都包含有杂散电阻、杂散电感、和杂散电容,各铝键合线之间还存在互感,为简化分析,铝键合线之间的互感忽略不计,且认为与铝键合线有关的参数主要是杂散电阻和杂散电感,每根铝线分别有杂散电阻和杂散电感的串联,与IGBT芯片有关的杂散参数主要是杂散电容。
IGBT芯片由MOSFET和BJT两部分组成,图2为IGBT芯片的典型内部结构。与MOSFET相关的杂散电容参数包括:门-源极金属化电容CM,门-源极金属氧化电容COXS,门-漏极交叠氧化电容COXD,门-漏极交叠耗尽层电容CGDJ,门-漏极交叠耗尽层电容CDSJ,其中CM与COXS组成CGE,COXD与CGDJ组成CGC;与BJT相关的杂散参数包括:射-集电极重分布电容CCER,基-集电极扩散电容CEBD,基-集电极耗散电容CEBJ,基极电导调制电阻RB。

图2 IGBT芯片的典型内部结构
2 铝键合线脱落故障的影响
由于功率波动等因素造成铝键合线脱落故障时,首先会改变其自身的杂散电阻和杂散电感。门-射极电压与终端电容有着直接的关系,所以铝键合线全部脱落会影响终端电容,进而又影响门-射极电压。
2.1 键合线脱落对门极杂散阻抗的影响
铝键合线是实现电连接的关键,通常为几根并联,每根键合线上由杂散电阻和杂散电感串联而成,如图3。当部分键合线脱落、断裂或翘曲时,并联根数减少,铝键合线的等效杂散电感和杂散电阻增大。
图3 杂散电阻和杂散电感等效电路
铝键合线故障也会影响终端电容,大电流的IGBT模块中每个单元通常由两个或更多IGBT芯片并联,图4为IGBT芯片的门极等效电路。CGC和CGE是影响门极电压的主要参数,CCE的影响可忽略。

图4 IGBT芯片门极等效电路
CGE计算公式为:
式中,AGE表示栅极多晶硅与发射极的金属重叠面积,dOX_GE表示他们之间的氧化层厚度,分别为真空介电常数和氧化层介电常数。铝键合线全部脱落导致CGE减小。
米勒电容CGC由COXD和CGDJ组成,计算公式分别为:
由公式可知CGDJ的值与VCE有关,因此在开通暂态过程中门-集极等效电容CGC并不是固定的值:
其中,AGD为IGBT芯片中MOSFET部分门-漏极交叠面积;q为电子电荷;NB为基区的掺杂浓度;εsi为硅的介电常数。由于键合线全部脱落会使AGD减小,CGDJ和COXD随之减小,因此CGC减小。
由上述分析可知,铝键合线部分脱落影响其等效杂散电阻和杂散电感,全部脱落后还会影响其等效杂散电容值。又由于栅极等效电容与铝键合线电阻数量级上的差异,铝键合线全部脱落时,杂散电容变化对门极电压的影响占主导。
2.2 杂散阻抗变化对门极电压波形的影响
IGBT模块杂散参数的变化导致门极开通电压波形发生改变。根据VCE和VGE的变化可将IGBT的开通暂态过程分为图5所示的3个阶段:

图5 IGBT器件开通暂态过程
阶段1(t1<t<t2):门极电压VGE开始上升但还未达到VGE(th),IGBT器件仍然处于关断状态。门极电流给CGE和CGDJ充电,充电时间常数为τ=(Rw+Rg)(CGE+CGDJ)。铝键合线部分故障杂散电阻增大,因此门极电压上升时间增大,上升速度减缓;芯片失效导致CGE减小,即门极回路内部杂散电容减小,所以门极电压上升时间减小,上升速度加快。
阶段2(t2<t<t3):门极电压超过VGE(th),IGBT器件导通。米勒电容CGC的存在,使得VGE出现米勒平台期,恒流源全部向CGC充电,因此米勒平台持续时间与CGC有关。键合线全部脱落导致CGC减小,所以米勒平台持续时间会缩短。捕捉米勒平台需要示波器具有很高的分辨率。
阶段3(t3<t<t4):VCE下降至通态饱和压降,VGE逐渐上升至稳态值。由式(3)可知,CGC=COXD为常数。同阶段一,铝键合线部分故障VGE上升速度减慢,芯片失效时VGE上升速度加快。
综上可知,第一阶段和第三阶段具有相同的变化规律,故在未能捕捉到米勒平台的情况下,可将第一、三阶段联合起来分析。
3 实验测试及结果
在实验室模拟实际工况下功率循环等因素造成IGBT器件铝键合线故障。研究铝键合线脱落过程中门极电压的变化规律。
图6为开关特性测试电路,Vdc=450 V,驱动电压高电平+15 V,频率为10 kHz,负载阻抗为3 mH,20 Ω,栅极电阻Rg=10 Ω,示波器采样频率为1.25 GS/s。测量铝键合线正常和分别脱落1-6根时IGBT模块的门极开通电压VGE,图7为正常和铝键合线发生脱落故障时门极开通电压波形比照图。
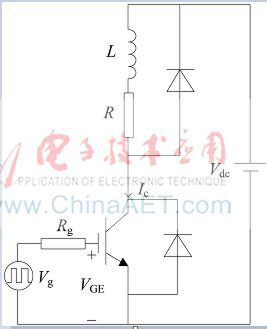
图6 测试电路
由图可以看出,当一块IGBT芯片上的铝键合线全部脱落即芯片失效时,VGE波形明显向左上方偏,即上升速率增大;当铝键合线发生部分脱落故障时,VGE波形向右下方偏,即上升速率减小,而且由于各种寄生参数的存在,其波形并不是随着铝键合线脱落根数的增加逐渐向下偏而是有所交叉。由于我们目的不是准确判断几根铝键合线脱落而是铝键合线是否已经出现脱落现象,而且一根铝键合线脱落会加速其他铝键合线脱落,所以只要监测出VGE发生异常就应该及时更换IGBT模块。

图7 铝键合线正常和故障时门极电压波形
4 故障特征信息提取
故障初期VGE波形变化可能不明显,人眼辨识存在一定的局限性,这就要求对所测信号进行处理,以便抽取出有用的故障信息或找出区别于电路正常工作信号的特征。本节将小波分析与信息熵结合,将小波包分解的能量信号作为故障特征量,求取其能谱熵值,通过熵值的变化来判断IGBT器件是否发生铝键合线故障。
将小波变换与信息熵结合,可以得到信号的小波能谱熵、小波时间熵等定义及其计算方法。IGBT器件老化失效使得VGE发生变化,意味着电压的频谱不一样,相应的各频带信号的能量也会发生变化,因此本文选用小波能谱熵的计算方法进行分析。
设E=E1,E2,…,Em,为信号VGE在m尺度上的小波能谱。根据正交小波变换特性,某一时间窗内信号的总功率E等于各分量功率Ej之和,设pj=Ej/E,则∑pj=1,相应的小波能谱熵的定义为:
式中pj表示尺度Ej的能量占整个函数能量的百分比,各分量的功率为:
式中,Dj(n)为小波分解系数,n为采样点数。为克服小波分解在高频段频率分辨率较差而在低频段时间分辨率差的问题,本文采用更精细的小波包分解。
小波能谱熵代表信号在各个小波尺度上能量分布均匀性。信号频率成分越简单,信号能量就越集中于少数几个尺度上,小波能谱熵就越小[11]。
按照式(5)、式(6)对电压信号进行小波包分解并计算能谱熵得到表1结果。
从表1可以看出,VGE的能谱熵可以作为表征铝键合线脱落故障的特征值。当铝键合线发生脱落1-5根时,VGE的能谱熵值减小26%~37%,虽然没有随铝键合线故障根数增加严格递减,但是相对于正常情况下也发生了较大变化;当铝键合线全部脱落时,其能谱熵值增大了99.96%,较正常值发生了很大变化。故用小波能谱熵的分析方法对IGBT铝键合线的脱落故障进行状态监测是可行的,这种方法物理意义明确且容易实现。

5 结论
本文在分析铝键合线故障对杂散阻抗和门极电压的影响的基础上,通过实验模拟铝键合线脱落故障并测量门极电压变化,得出如下结论:
(1)铝键合线故障前后,门极开通电压发生了变化且表现出一定的规律:部分铝键合线脱落VGE向右下角方向偏,全部脱落时其波形向左上角方向偏。
(2)通过小波能谱熵算法计算铝键合线故障前后的能谱熵值,故障值较正常值变化明显,结果直观、准确,为实现IGBT器件的状态监测提供了依据。
参考文献
[1] Yang Shaoyang,BRYANT A,MAWBY P,et al.An industrybased survey of reliability in power electronic converters[J].IEEE Transactions on Industry Applications,2011,47(3):1441-1451.
[2] Jonas Sjolte,Gaute Tjensvoll,Marta Molinas.Reliability analysis of IGBT inverter for wave energy converter with focus on thermal cycling[J].IEEE Transactions on Industry Applications,2014,1-7.
[3] 赖伟,陈民铀,冉立,等.老化试验条件下的IGBT失效机理分析[J].中国电机工程学报,2015(20):5293-5300.
[4] 禹鑫,杜明星,窦汝振,等.IGBT功率模块键合线故障下的温度特性研究[J].电力电子技术,2015(2):55-57.
[5] 王春雷,郑利兵,方化潮,等.键合线失效对于IGBT模块性能的影响分析[J].电工技术学报,2014(S1):184-191.
[6] JI B,PICKERT V,CAO W P,et al.Onboard condition monitoring of solder fatigue in IGBT power modules[C].IEEE International Symposium onDiagnostics for Electric Machines,Power Electronics and Drives(SDE MPED),2013,9-15.
[7] Nishad PatH,Diganta Das,Kai Goebel,et al.Identification of failure precursor parameters for insulated gate bipolar transistors(IGBTs)[C].International Conference on Prognostics and Health Management,2008,1-5.
[8] Wei Kexin,Du Mingxing,Xie Linlin,et al.Study of bonding wire failure effects on external measurable signals of IGBT module[J].IEEE Journals Magazines,2014,14(1):83-89.
[9] 杨旭.基于饱和压降测量的IGBT功率模块状态评估方法研究[D].重庆:重庆大学,2012.
[10] 周雒维,周生奇,孙鹏菊.基于杂散参数辨识的IGBT模块内部缺陷诊断方法[J].电工技术学报,2012(5):156-163.
版权声明:本文内容由互联网用户自发贡献,该文观点仅代表作者本人。本站仅提供信息存储空间服务,不拥有所有权,不承担相关法律责任。如发现本站有涉嫌抄袭侵权/违法违规的内容, 请发送邮件至 [email protected] 举报,一经查实,本站将立刻删除。











